
- 网站首页
- 关于我们
- 团队介绍
- 项目投资
- 新闻资讯
键合设备——先进封装领域关键设备(下)
发布时间:2025-04-18(接上篇)
三、先进封装晶圆键合设备企业
根据YOLE数据,临时键合/解键合设备市场在2027年有望以7%的CAGR增长到1.76亿美元,目前临时键合设备市场规模较小,有待下游生产厂商量产技术突破。键合设备头部厂商BESI预计混合键合工艺将于2025年逐步导入存储器生产,并在2027年左右应用于手机处理芯片。2030年前混合键合设备累计需求预计将超过1400套,对应设备价值量约为28亿欧元。

在键合设备领域,全球主要的设备供应商包括BESI、K&S(KulickeandSoffa)、ASMPT、EVG和SUSS等,混合键合设备以荷兰BESI,临时键合与临时解键合设备以奥地利EVG、德国SUSS等企业占据主要市场地位,国产替代处于刚起步阶段。
国内拓荆科技、芯源微、青禾晶元、吾拾微、芯慧联等在晶圆键合设备上布局较早:
拓荆科技的键合机系列包括Dione 300和Dione 300F,主要用于3D IC、先进封装和CIS(图像传感器)等领域,该系列设备可实现在常温下多材料表面的晶圆键合。2023年首台晶圆对晶圆键合产品Dione 300顺利通过客户验证,并获得复购订单。混合键合系列产品还包括芯片对晶圆键合表面预处理产品以及键合套准精度量测产品。
芯源微推出了临时键合机KS-C300-TB及激光/机械解键合机KS-S300-DBL/DBM,主要针对 Chiplet 技术解决方案,兼容国内外主流胶材工艺,能够适配60μm 及以上超大膜厚涂胶需求,可实现高对准精度、高真空度环境、高温高压力键合工艺,键合后产品TTV 及翘曲度表现优异,适配开发的机械、激光解键合技术。
青禾晶元近期发布了全球首台独立研发C2W&W2W双模式混合键合设备SAB 82CWW系列,可用于存储器、Micro-LED显示、CMOS图像传感器、光电集成等领域。该产品采用灵活的模块化设计,将C2W和W2W两种技术路线集成到一台键合设备里面,同时可以兼容8寸、12寸晶圆键合,SAB 82CWW系列提供片间同轴和红外穿透两种对准方式,应对不同尺寸和材质的芯片,实现对准精度±30nm、键合精度±100nm的,C2W单键合头UPH最高可达1000片/小时。通过创新键合技术,青禾晶元的键合设备能够满足Micro-LED对亚微米级对准精度和高可靠性的需求。同时青禾晶元还布局了临时键合、解键合等设备,也可用于自研的异质碳化硅衬底的生产中。

(青禾晶元推出的SAB 82CWW系列混合键合设备)
芯慧联开发的3DSIXI晶圆混合键合设备,适用于12寸晶圆熔融键合及混合键合,可集成对准精度检测和气泡缺陷检测,适用于CIS、3DNAND、DRAM、先进封装。开发的晶圆熔融键合设备,可用于硅、玻璃的基板材料,适用于BSI、半导体光学领域。
吾拾微推出了WSBOND-1000 系列晶圆键合机,是国内较早开始研发键合设备的公司,已开发了临时键合、解键合、以及永久键合设备,目前主要应用在碳化硅、无图形片的键合。吾拾微的键合工艺较为灵活,支持多种键合工艺,如热压键合、共晶键合、阳极键合等,可以根据不同的键合材料和工艺要求,灵活选择合适的键合方式。
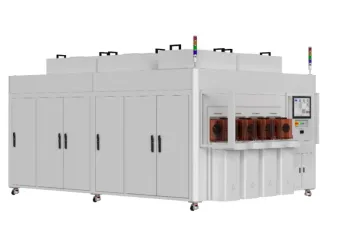
(吾拾微电子推出的12英寸晶圆永久键合设备WPB-Heracles300)
也有业内的键合设备厂商反馈,目前产线购买使用的键合设备,很少有同样型号的复购,一部分原因是国内厂商尚未跑通工艺,同时键合设备面向的领域也不一样,HBM、CIS、CoWoS等不同类型的堆叠形式,各家客户也都在摸索适合自己的键合方式,所走路线会有所不同,也就注定了现阶段,键合设备偏向定制化,小批量的模式,键合设备的批量化,需要下游的生产厂商与键合设备厂商、减薄设备厂商、材料厂商等通力合作跑通量产工艺。
投资建议:
从目前主流的技术路线来看,键合设备是对先进封装的核心关键设备之一,对突破HBM、CoWoS、高端CIS等领域的高端集成芯片是必不可少的,具有向前发展的必然性。同时国内量产工艺路线经过4年多发展,部分头部制造厂已取得一定成绩,但到量产应用还有一定时间。
同时考虑临时键合设备市场空间较小,建议关注非单一临时键合/解键合设备厂商,同时还能够做永久键合、混合键合设备,或者制做其他设备的厂商。
考虑到键合设备厂商与下游各类2.5D/3D先进封装制造端的深度绑定程度,待未来2.5D/3D堆叠工艺取得突破,必将带动一起合作开发堆叠工艺的键合设备厂商,建议关注从早期就介入键合设备赛道,并已取得客户验证的键合设备厂商,如拓荆、芯慧联、青禾晶元、吾拾微等。
风险提示:
(1)国产封装厂商及键合设备厂商发展不及预期的风险,等待期漫长;
(2)下游封装厂商可能会优先选择国外设备先期突破,国产键合设备厂商作为backup二供;
(3)行业竞争加剧,已有多家国内企业进入键合设备的赛道,但作为新技术的研发类设备,量产路线尚未完全打通,未来很可能出现一家先突破,赢家通吃的情况,建议深入考察标的公司。
【完】